晶圓切割工藝進入自動化時代,騰盛深度聚焦半導體精密切割
發(fā)布時間:2022-12-01 16:07:31 瀏覽:185次 責任編輯:騰盛精密

精密晶圓切割機主要用于硅片、陶瓷、玻璃、砷化鎵等材料的加工,也被廣泛應用于集成電路 (IC)、半導體等行業(yè)。在過去三十年期間,切片系統(tǒng)與刀片已經(jīng)不斷地改進以對付工藝的挑戰(zhàn)和接納不同類型基板的要求。目前切割工藝已進入自動化時代。
晶圓切割工藝進入自動化時代
晶圓(wafer) 是制造半導體器件的基礎性原材料。極高純度的半導體經(jīng)過拉晶、切片等工序制備成為晶圓,晶圓經(jīng)過一系列半導體制造工藝形成極微小的電路結構,再經(jīng)切割、封裝、測試成為芯片,廣泛應用到各類電子設備當中。
硅晶圓切割工藝是在“后端”裝配工藝中的第一步,將晶圓分成單個的芯片,用于隨后的芯片接合、引線接合和測試工序。
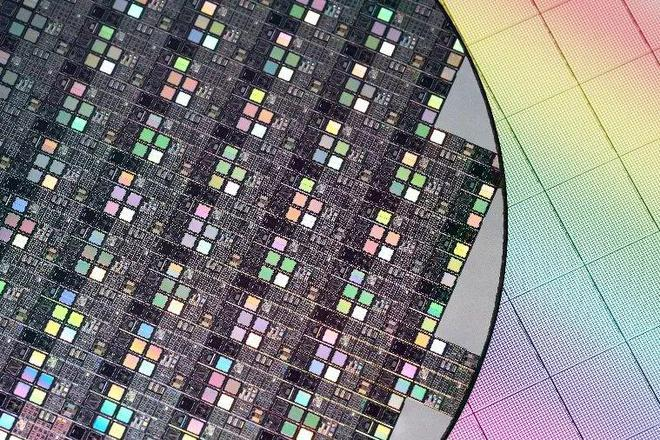
▲圖源:360圖片
迄今為止,在芯片的封裝工序中,切割工藝的發(fā)展歷史大致可分為以下三個階段——
第一階段:金剛刀切割機
19世紀60年代是硅晶體管的發(fā)展初期,當時主要應用的切割裝置是金剛石切割機,采用的是劃線加工法,類似于劃玻璃的原理。這種方法非常依賴于人工操作,加工精度低,勞動程度強。因此,加工成品率很低。
第二階段:砂輪切割機
60年代中期進入集成電路時代,晶圓開始向2吋、3吋等大直徑化發(fā)展。同時,晶圓厚度也從100微米加厚到200-300微米。在這種情況下,采用原來的工藝方法并不適用。此時,日本研制出世界第一臺極薄金剛石砂輪切割機,預示著切割機進入了薄金剛砂輪切割機時代。
第三階段:自動化切割機
隨著半導體的需求和產(chǎn)量逐漸增大,對切割的成品率和效率的要求越來越高。此時,就有了自動化切割機的需求。在需求催生和技術發(fā)展下,晶圓切割工藝進入自動化時代。
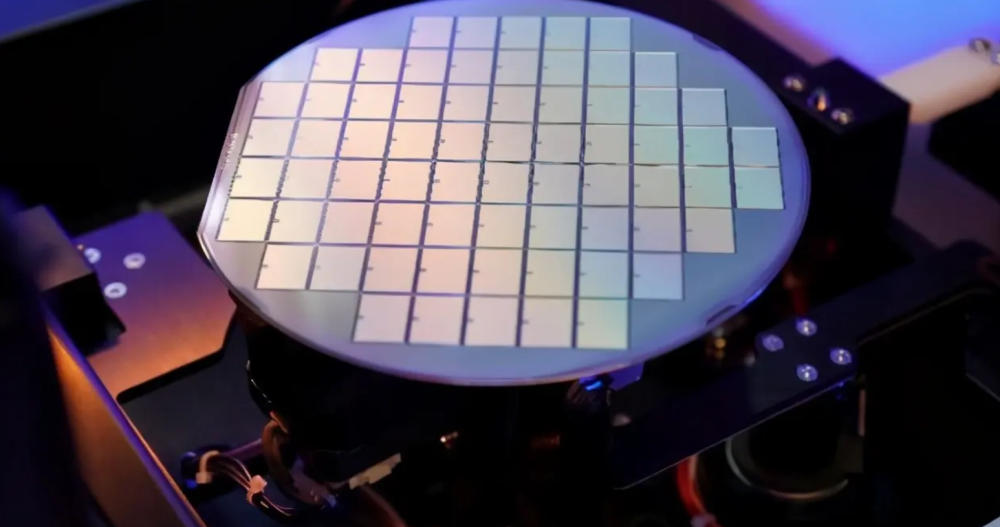
▲圖源:360圖片
封裝技術催生全自動切割機
隨著半導體應用市場對于芯片性能的不斷追求,芯片制造的成本也在持續(xù)增加,創(chuàng)新的先進封裝技術的出現(xiàn)也成為必然。對于傳統(tǒng)封裝方式的創(chuàng)新,促成了晶圓級封裝技術的“應運而生”。
晶圓級封裝技術,直接在晶圓上進行大部分或全部的封裝、測試程序,然后再進行安裝焊球并切割,從而產(chǎn)出一顆顆的IC成品單元,可以將封裝尺寸減小至IC芯片的尺寸,生產(chǎn)成本大幅下降,并且把封裝與芯片的制造融為一體,改變了芯片制造業(yè)與芯片封裝業(yè)分離的局面。

▲圖源:360圖片
晶圓尺寸與工藝制程并行發(fā)展,每一制程階段與晶圓尺寸相對應。
A:制程進步→晶體管縮小→晶體管密度成倍增加→性能提升。
B::晶圓尺寸增大→每片晶圓產(chǎn)出芯片數(shù)量更多→效率提升→成本降低。
目前6吋、 8吋硅晶圓生產(chǎn)設備普遍折舊完畢,生產(chǎn)成本更低,主要生產(chǎn) 90納米以上的成熟制程。部分制程在相鄰尺寸的晶圓上都有產(chǎn)出。5納米至 0.13微米則采用 12 吋晶圓,其中28納米為分界區(qū)分了先進制程與成熟制程,主要原因是28納米以后引入FinFET等新設計、新工藝,晶圓制造難度大大提升。與此同時給精密切割提出了更高的要求,作為IC后封裝生產(chǎn)過程中關鍵設備之一的切割機,也隨之由6吋、8吋發(fā)展到12吋。
騰盛深度聚焦半導體切割
縱觀過去的半個世紀,大規(guī)模集成電路時代已向超大規(guī)模方向發(fā)展,集成度越來越高,劃切槽也越來越窄,其對切割的工藝要求越發(fā)精細化,需要全自動、高精度的切割機來滿足生產(chǎn)需求。
切割機作為半導體芯片后道工序的加工設備之一,用于晶圓的切割、分割或開槽等微細加工,其切割的質量與效率直接影響到芯片的質量和生產(chǎn)成本。
JIG SAW是自動切割治具,TAPE SAW是手動切割的。通常大批量生產(chǎn)需要JIG SAW。JIG SAW全自動精密切割機能夠實現(xiàn)橫向精密微位移和自動進給;手動和自動切割兩種模式,自動化程度高,操作安全、可靠;自動顯示切割進給速度、主電機轉速等。

以JIG SAW切割設備—騰盛全自動切割擺盤機FDS3200為例,該機臺采用創(chuàng)新布局方案,集上料、切割、清洗、分選、擺盤等多功能于一體。可兼容多種規(guī)格、多種類型產(chǎn)品,同時具備多種下料方式及多樣化切割系統(tǒng)。騰盛FDS3200裝載了自主開發(fā)的VISION視覺平臺,可提供豐富的視覺檢測配置。FDS3200,雙工位,雙刀切割,雙軸擺盤及高速搬運系統(tǒng),可對應最小產(chǎn)品包裝尺寸3mm*3mm,目前設備在客戶應用中實測UPH數(shù)據(jù)≥17K,能夠有效提高流水線工作效率,更適用于領先的半導體封裝企業(yè)。
在進口替代疊加需求旺盛雙重因素影響下,中國大陸市場對行業(yè)市場空間不斷擴大,為國內封測廠商國產(chǎn)化替代提供機遇。Tensun騰盛充分相信國產(chǎn)半導體切割機行業(yè)具有巨大的發(fā)展前景!

————
聲明:本文部分內容參考出處有:
1.「大科普:最全面的半導體晶圓工藝介紹 」,來源:中信證券徐濤、胡葉倩雯、晏磊
2.「芯片劃片機國產(chǎn)替代頭部企業(yè)」,來源:失效分析實驗室
3.「全球與中國晶圓切割機行業(yè)現(xiàn)狀調研與發(fā)展趨勢預測報告(2022年版)」,來源:產(chǎn)業(yè)調研網(wǎng)
如有侵權等行為,可聯(lián)系我方刪除。



 深圳市騰盛精密裝備股份有限公司
深圳市騰盛精密裝備股份有限公司 

